工法
3D実装
目次
PoP・3D-MID実装とは…
PoP (Package On Package)とは、これまで基板上に2次元的に配列されていたICパッケージを、積層することによって集積度を上げる技術です。
またパッケージ(PKG)をスタック構造にすることで、機能の異なるPKGを組合せることができます。
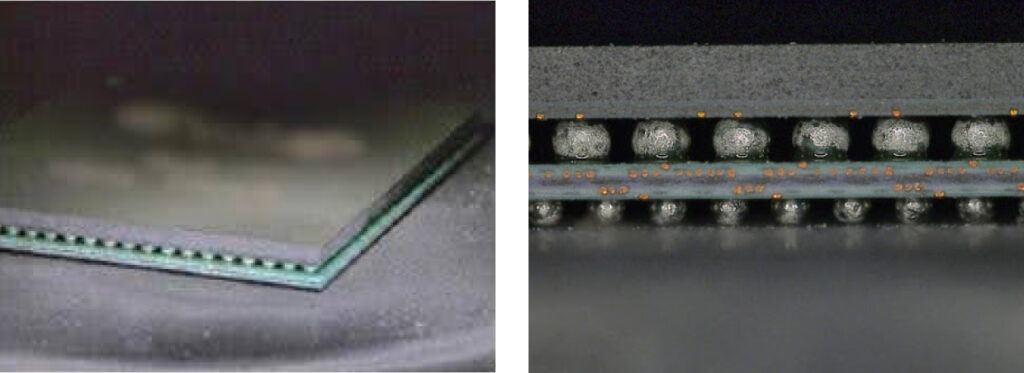
3D-MID(3D-Molded Interconnect Device)とは、成形回路部品とも呼ばれ、三次元形状の樹脂成形品の表面に電極や回路などが形成されたもののことです。
プリント基板(PCB)やフレキシブル基板(FPC)の部品点数を削減して製品を軽量薄型化したり、電化製品の形状の自由度を高めて新しい設計を実現する技術です。

PoP・3D-MID実装のメリット
PoPは、より高密度・高集積化を図ることが出来るため、主にモバイル機器に使用されている実装技術です。
メモリとプロセッサの組合せを変えることが容易なため、ユーザーの自由度が向上します。
3D-MIDは、これまでプリント基板やFPC基板を使って組み込んでいた配線や電子部品を、製品筐体などの樹脂成形品の表面に形成することによって、製品内部の部品スペースを削減したり、基板を収めるための形状の制約を軽減したりできる技術です。
これまで平面でしか行えなかった回路形成や部品実装が、三次元形状でもできるようになります。
フラットな形状の電化製品を立体的かつ複雑に設計したり、逆により軽薄・小型にするなど、多様なデザインが実現できます。
PoP・3D-MID実装の使用例
高密度・高集積実装基板
携帯電話・携帯音楽プレイヤー・カーナビなどの小型化・高密度化が求められる製品基板で、ICパッケージの基板専有面積を抑えるため、PoP実装が採用されています。
狭小・異形箇所への基板(回路)搭載
電化製品のデザイン自由度や機器性能を向上させるため、基板(回路)の集積化・3D構造化が進められており、PoPや3D-MID実装工法の技術が活かされています。