2014.5.29
低Ag化するはんだ合金
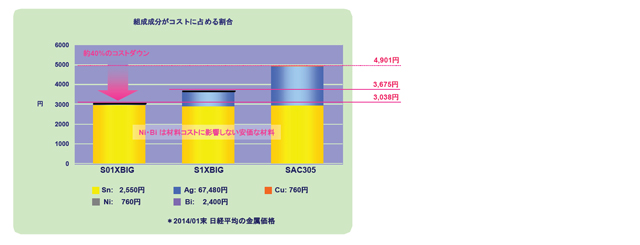
はんだの鉛フリー化が進む中、長くSAC305(Sn, Ag3.0%, Cu0.5%)の合金組成がその主流を成してきましたが、近年投機の対象になった主成分のAgの価格変動リスクを回避するため、Ag含有
2014.5.29
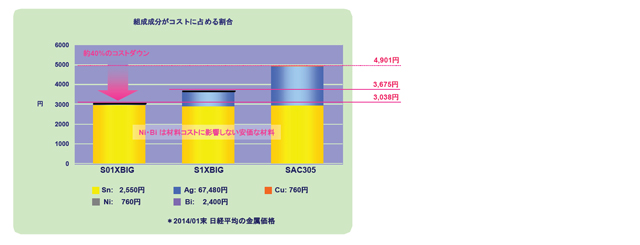
はんだの鉛フリー化が進む中、長くSAC305(Sn, Ag3.0%, Cu0.5%)の合金組成がその主流を成してきましたが、近年投機の対象になった主成分のAgの価格変動リスクを回避するため、Ag含有
2013.2.13
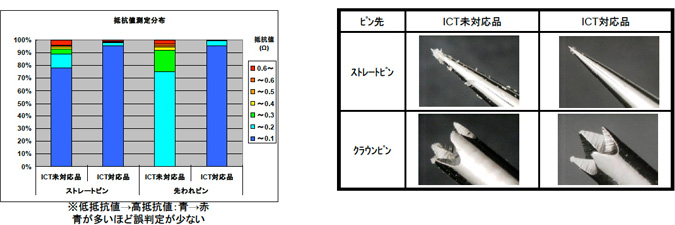
ICT (インサーキットテスト)は、基板を破壊せずに、不良の発見が可能となる検査です。 そのため目視検査や外観検査装置では発見できないような不良を見つけることができます。 しかし、はんだペーストの種
2013.1.20
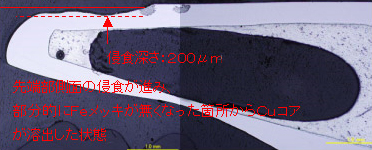
Sn/Pb共晶はんだに替わるPbフリーはんだとして、JEITAが中心となってSn3.0Ag0.5Cuを推奨したことにより、やに入りはんだでも多くのユーザーがこの組成を指定している。しかし、その後の経済
2013.1.20
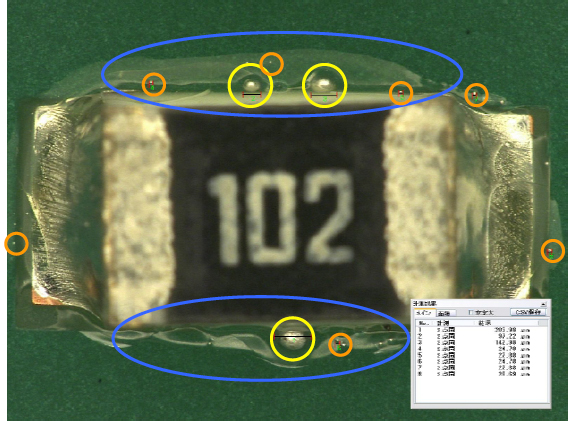
錫鉛共晶はんだから鉛フリーはんだにシフトしていくなかで、高温条件でのリフロー挙動の違い、はんだの溶解性の違いが主原因となるソルダボールへの対応が必要となっています。サイドボールのよ抑止のための実装行程
2012.12.23

携帯電話に代表されるように、電子機器は引き続きコンパクト化が進み、BGAやCSPといった省スペース部品が広く使用されるようになった。それに伴い、はんだボールとはんだが接合しない「枕不良」と呼ばれる現象
2012.12.21
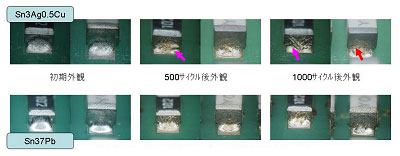
1. はじめに欧州の特定物質使用禁止指令(RoHS指令)施行を2006年7月に控え、現在、鉛フリーハンダへの移行が急ピッチで進められています。そして、Sn-3.0Ag-0.5Cu系ハンダ(以下SACと
2012.12.21

ヨーロッパWEEE及びRoHS指令アップデート-2005年7月 EU加盟国内全域において近日施行される当該法律は、加盟国内での電気・電子機器の生産及び廃棄を規制します。 以下の情報は主に英国内の状
2012.12.20

Pbフリーはんだ付けににおいては、厳しいリフロープロファイルに耐え、持続・安定した活性力と優れた耐熱性が要求されます。これらの性能を満たした最新のPbフリーソルダペーストの選択が重要となってきます。一
2012.12.14
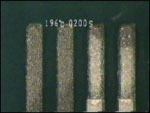
ここでは、Pbフリー基板に弘輝Pbフリーはんだペーストを使用し、Sn・Pb処理のQFP部品と一緒にリフローした時の影響を見ました。 下記のように、2つの条件でのはんだ付け部を同時に観察しました。
2012.12.10
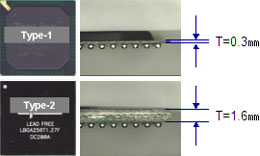
リフロー温度プロファイルの設定は、PCBに実装されている部品により異なります。 ここでは一般的な2つのタイプのBGAを同時実装した時の課題を分析します。 下記のような2種類のBGAを用意し、溶融状